|
|
|
|
|
| HOME > PRODUCTS MENU > Low stress bonding paste (LSA7701) |
|
|
|
|
|
|
|
 |
|
|
 |
|
 |
|
|
|
|
|
|
|
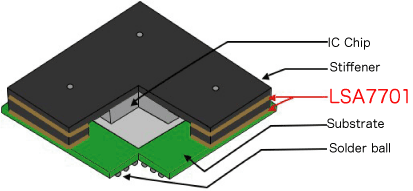 |
|
|
|
|
|
|
|
This adhesive is developed for LSI Package as one-liquid type thermosetting adhesive paste.
It has low stress as rubber area and has excellent adhesion to many kinds of metals as well as organic material.
While it has been applied between different coefficient of thermal expansion materials, it works as compliant layer to absorb the stress between layers and becomes a excellent stress relief bonding. |
|
|
|
|
|
|
|
 |
|
|
|
|
|
|
|
 |
Excellent adhesive strength between materials with different rate of thermal expansion. (low stress in rubber area) |
|
|
|
 |
High purity, excellent wet endurance,non-conductivity,and available for the solder reflow process. |
|
|
|
 |
Strong adhesive strength to the various kinds of organic and metal material. |
|
|
|
 |
Can be transformed into any shape and applied to any part of the material with screen printing. |
|
|
|
 |
Designed to improve productivity and lower processing costs. (one liquid type) |
|
|
|
|
|
|
|
 |
|
|
|
|
|
|
|
 |
Bonding the stiffener of BGA |
|
 |
Bonding IC chip with interposer etc |
|
|
|
|
|
 |
|
|
|
|
|
|
|
 |
Screen Printing |
|
|
|
 |
Drying Condition |
80°C for more than 30mins. |
|
|
 |
Thermo Compression Bonding |
130~180°C for 10 ~ 20secs |
|
|
|
|
|
|
 |
Curing condition |
175°C for more then 60mins |
|
|
|
*Condition may differ by adhered, printing thickness, shape, or others |
|
|
|
|
|
|
|
|
 |
|
|
|
|
|
|
|
|
|
 |
Young's Modulus |
3.6Kg/mm2 |
|
|
 |
Broken Expansion |
130% |
|
|
 |
Broken Strength |
1.1kg/mm2 |
|
|
 |
Adhesion |
|
|
|
|
|
 |
Copper Foil/Cu |
2.0kgf/cm |
|
|
|
|
 |
Copper Foil/AL |
2.5kgf/cm |
|
|
|
|
 |
Copper Foil/SUS |
2.0kgf/cm |
|
|
|
|
 |
PI/Ni |
1.6kgf/cm |
|
|
 |
Die-Electric Resistance |
|
|
|
|
|
 |
Initial Value |
1 X 1014Ω |
|
|
|
|
 |
Biased Test |
1 X 1013Ω |
|
|
 |
Die-electric Resistance Test Condition |
|
|
|
|
|
|
|
|
|
 |
90µm(Conductor width50µm Space40µm) |
|
|
|
|
|
Au Plated Copper pattern PI Substrate |
|
|
|
|
 |
Evaluation Condition |
85°C/85%RH/12V/504hr |
|
|
|
|
|
|
|
|
|
|
|
|
|
 |
|
|
|
|
|
|