走査電子顕微鏡およびイオンミリング装置(断面試料作製装置)を導入しました。
低真空観察可能な、走査電子顕微鏡(FlexSEM1000Ⅱ/日立ハイテク)を導入しました。
本装置は、光学顕微鏡では観察不可能な、微小で凹凸のある表面構造を三次元的な画像として観察できます。また、イオンミリング装置(ArBlade5000/日立ハイテク)も導入しました。本装置は、走査電子顕微鏡(SEM)の高性能/多機能化が進むにつれてSEMの用途が拡大し、評価目的を実現するための試料前処理の難易度が高まったことに対応できます。
<特長>
・本装置は、試料表面に導電膜による表面コーティングを行わずに表面状態を観察できます。
・異物等の寸法情報に加えて、反射電子像により組成情報をコントラストとして捉えることができます。
・ArBlade5000の導入で試料への応力負荷の影響を排除、より精細な断面作成も可能になりました。
1)走査電子顕微鏡
<主な仕様>
・分解能:二次電子像分解能 4nm(加速電圧20kV)/15nm(加速電圧1kV)
反射電子像分解能5nm(加速電圧20kV)
・倍 率:×6〜300,000
・観察像:二次電子像/反射電子像/低真空二次電子像
・加速電圧:0.3〜20kV
・試料サイズ:Φ80mm 高さ40mm(観察可能範囲:Φ64mm)
<SEM像で得られる情報>
・二次電子像:試料表面の凹凸情報
・反射電子像:試料表面の組成情報
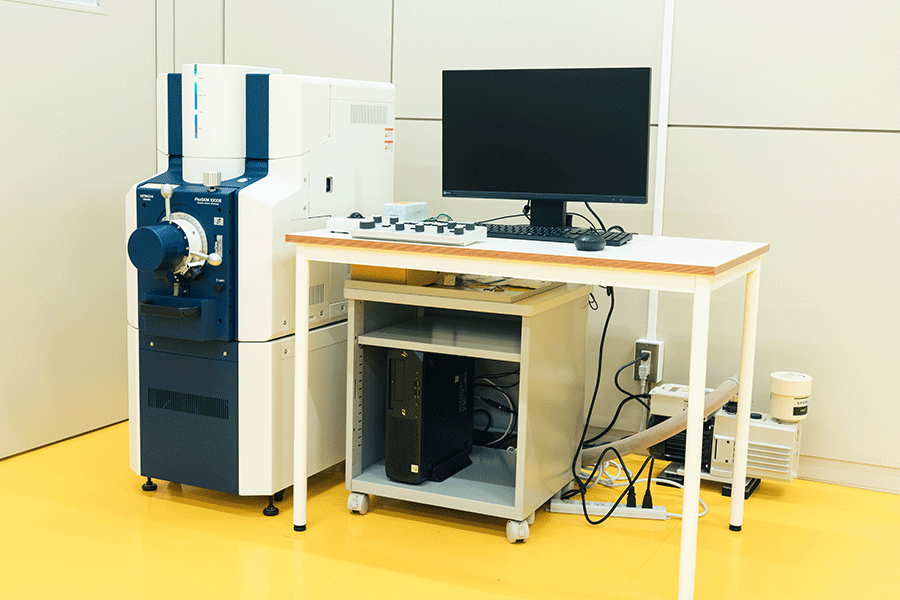

2)イオンミリング装置
<主な仕様>
・基本性能 :平面ミリング、断面ミリング
・試料サイズ:最大50mmΦ×25mmH(平面ミリング)、
最大20mmW×12mmD×7mmH(断面ミリング)
・加工範囲 :32mmΦ(平面ミリング)、8mm(断面ミリング)
<用途>
・平面ミリング:機械研磨試料の研磨傷やダレ除去
・断面ミリング:研磨による試料作製が困難な亀裂やボイドの観察


【お問い合わせ先】
シーマ電子株式会社
TEL:0551-23-0642